Increase your productivity with our powerfully versatile atomic force microscope
The Park XE15 includes many unique capabilities that make it ideal for shared labs that handle a diverse range of samples, researchers doing multi variant experiments, and failure analysis engineers working on wafers. Its reasonable price and robust feature set also make it one of the best value large-sample AFMs in the industry.
Request for QuoteBrochures
Unique MultiSample™ scan boosts research productivity
Maximize your efficiency with the only AFM that offers the ability to image and measure multiple samples in one pass. Simply load the stage with your samples and initiate the scan process. This feature also allows you to scan the samples under identical environmental conditions, improving the accuracy and reliability of your data.
Large sample size increases possibilities
Unlike most AFMs, the Park XE15 can scan a sample of up to 150 mm x 150 mm. This makes it ideal for researchers wanting to scan larger samples or failure analysis engineers who need to place silicon wafers on the stage.
Features adaptable to any need
The Park XE15 features our most inclusive set of scan modes and can process a range of sample sizes. This makes it uniquely suited to shared labs with a wide range of individual requirements.
The Most Extensible AFM Solution
Supports Park’s most extensive range of SPM modes and options in the industry
Today's researchers need to characterize a wide range of physical properties under diverse measurement conditions and sample environments. Park Systems provides the most extensive range of SPM modes, the largest number of AFM options, and the best option compatibility and upgradeability in the industry for advanced sample characterization.
Park XE15 has the most Extensive range of SPM modes (*Optionally available)
Standard Imaging
Chemical Properties*
Force Measurement*
Electrical Properties*
- Conductive AFM
- I-V Spectroscopy
- Kelvin
Probe Force Microscopy (KPFM)
- Scanning Capacitance Microscopy (SCM)
- Scanning Spreading-Resistance Microscopy (SSRM)
- Scanning Tunneling Microscopy (STM)
- Photo Current Mapping (PCM)
Magnetic Properties*
Dielectric/Piezoelectric Properties*
- Electrostatic Force Microscopy (EFM)
- Dynamic Contact EFM (EFM-DC)
- Piezoresponse Force Microscopy (PFM)
Mechanical Properties*
Thermal Properties*
The most convenient sample measurements with MultiSample™ scan
Park XE15 MultiSample™ scan system
- Automated imaging of multiple samples in one pass
- Specially designed multi-sample chuck for the loading of up to 16 individual samples
- Fully motorized XY sample stage travels up to 150 mm x 150 mm
Using the motorized sample stage, MultiSample Scan™ enables programmable multiple region imaging in step-and-scan automation.
Here’s how it works:
1. Register multiple scan positions defined by a user
2. Image from the first scan position
3. Lift a cantilever
4. Move the motorized stage to the next user defined coordinate
5. Approach
6. Repeat scan
The registration of multiple scan positions is easily carried out by either entering sample-stage coordinates or sample de-skewing by two reference points. This automated feature greatly increases productivity by reducing the need for your interaction during the scan process.

Accurate XY Scan by Crosstalk Elimination
Park Systems’ advanced Crosstalk Elimination (XE) scan system effectively addresses all of the above-mentioned problems. In this configuration, we used a 2-dimensional flexure stage to scan the sample in only the XY direction, and a stacked piezoelectric actuator to scan the probe cantilever in the Z direction only. The flexure stage used for the XY scanner is made of solid aluminum. It demonstrates high orthogonality and an excellent out-of-plane motion profile. The flexure stage can scan large samples (~1 kg) up to a few 100 Hz in the XY direction. This scan speed is sufficient because the bandwidth requirement for the XY axes is much lower than that for the Z axis. The stacked piezoelectric actuator for the Z-scanner has a high resonance frequency (~10 kHz) with a high pushpull force when appropriately pre-loaded.
XE scan system

- independent, loop XY and Z flexure scanners for sample and probe tip
XY flexure scanner

- Flat and orthogonal XY scan with low residual bow
XE-Peformence

Figure 9. Zero background curvature by Park Systems XE-system (a) and typical background curvature of a conventional AFM system with a tube scanner (b). (c) shows the cross section of these background curvatures.
Figure 9. shows unprocessed AFM images of a bare silicon wafer taken with the XE-system (a), and with a conventional AFM (b). Since the silicon wafer is atomically flat, most of the curvatures in the image are scanner-induced artifacts. Figure 9. (c) shows the cross section of the images in Figure 9. (a) and (b). Since the tube scanner has intrinsic background curvatures, the maximum out-of-plane motion is as much as 80 nm when the X-axis moves 15 μm. The XE scan system has less than 1nm of out-of-plane motion for the same scan range. Another advantage of the XE scan system is its Z-servo response. Figure 10. is an image of a porous polymer sphere (Styrene Divinyl Benzene), whose diameter is about 5 µm, taken with the XE-system in Non-Contact mode. Since the Z-servo response of the XE-system is very accurate, the probe can precisely follow the steep curvature of the polymer sphere as well as small porous surface structures without crashing or sticking to the surface. Figure 11. shows another example that demonstrates the high performance of the z-servo response with a flat background.


Figure 10. Figure 11.
Better tip life, sample preservation, and accuracy with True Non-Contact™ Mode
In True Non-Contact™ Mode, the tip-sample distance is successfully maintained at a few nanometers in the net attractive regime of inter-atomic force. The small amplitude of tip oscillation minimizes the tip-sample interaction, resulting in superb tip preservation and negligible sample modification.
True Non-Contact™ Mode

- Less tip wear = Prolonged high-resolution scan
- Non-destructive tip-sample interaction = Minimized sample modification
- Immunity from parameter dependent results
Tapping Imaging

- Quick tip wear = Blurred low-resolution scan
- Destructive tip-sample interaction = Sample damage and modification
- Highly parameter-dependent
Longer Tip Life and Less Sample Damage
The sharp end of an AFM tip is so brittle that once it touches a sample, it becomes instantly blunt and limits the resolution of an AFM and reduces the quality of the image. For softer samples, the tip will damage the sample and also result in inaccuracies of sample height measurements. Consequently, preserving tip integrity enables consistent high resolution and accurate data. True Non-Contact Mode of the XE-AFM superbly preserves the tip, resulting in a much longer tip life and less sample damage. The figure, displayed in 1:1 aspect ratio, shows the unprocessed raw data image of a shallow trench isolation sample imaged by the XE-AFM, whose depth is also confirmed by scanning electron microscope (SEM). The same tip used in the imaging of the sample shows no tip wear even after taking 20 images.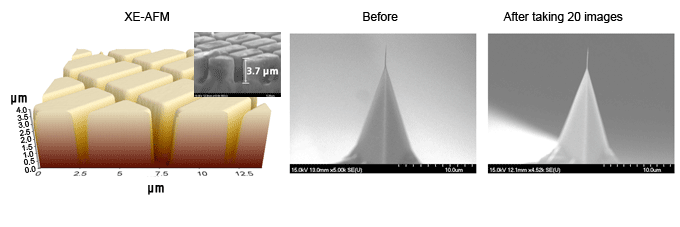
Park XE15 features
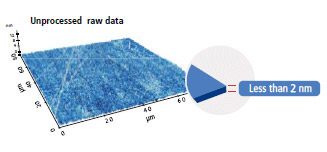 The XY scanner consists of symmetrical 2-dimensional flexure and high-force piezoelectric stacks provides high orthogonal movement with minimal out-of-plane motion as well as high responsiveness essential for precise sample scanning in the nanometer scale.
The XY scanner consists of symmetrical 2-dimensional flexure and high-force piezoelectric stacks provides high orthogonal movement with minimal out-of-plane motion as well as high responsiveness essential for precise sample scanning in the nanometer scale.
Driven by a high-force piezoelectric stack and guided by a flexure structure, its rigidity allows it to move at higher speeds in the vertical direction than the scanners used in conventional AFMs. The maximum Z scan range can be extended from 12 µm to 25µm with the optional long range Z scanner (optional).

The AFM head is easily inserted or removed by sliding it along a dovetail rail. The low coherency of the Super Luminescence Diode (SLD) enables accurate imaging of highly reflective surfaces and precise measurements for pico-Newton Force-distance spectroscopy. The SLD wavelength eliminates interference issues for users interested in combining the AFM with experiments in the visible spectrum.

The specially designed multi-sample chuck can load up to 16 individual samples, which can be scanned sequentially by MultiSample Scan Automation. The unique head design allows for easy side access to the sample tip.

The measurement location of the sample is easily and precisely controlled by the integrated motorized XY stage. The travel range of the XY sample stage can be configured for either 150 mm x 150 mm. The encoders, if used with the motorized stages, enable higher positioning repeatability for accurate sample positioning. The encoded XY stage travels in 1 µm resolution with 2 µm repeatability, and the encoded Z stage, in 0.1 µm resolution with 1 µm repeatability

The Z stage and focus stage engage the cantilever with the sample surface while constantly maintaining a clear field of vision for the user. And because the focus stage is motorized and software controlled, it has the precision necessary for transparent samples and liquid cell applications.

The nanoscale signals from the AFM are controlled and processed by the high performance Park XE electronics. With its low noise design and high speed processing unit, Park XE electronics successfully realize True Non-Contact™ mode ideal for nanoscale imaging as well as precise voltage and current measurement.
• High performance processing unit of 600 MHz and 4800 MIPS speed
• Low noise design for precise voltage and current measurement
• Versatile system to utilize various SPM techniques
• External Signal Access Module to access AFM input/output signals
• Maximum 16 data images
• Maximum data size: 4096 × 4096 pixels
• ADC/DAC in 16 bit, 500 kHz speed
• Electric noise isolation from PC by TCP/IP connection
Park XE15 Specifications
Scanner
Z Scanner
Guided high-force flexure scanner
Scan range : 12 µm (optional 25 µm)
Height noise level: 50 pm
(RMS, at 0.5 kHz bandwidth)
XY Scanner
Single module flexure XY-scanner with closed-loop control
Scan range : 100 µm × 100 µm
Stage
Z stage range : 25 mm (Motorized)
Focus travel range : 20 mm (Motorized)
Optional precision encoders for repeatable XY positioning
XY stage travel range : 150 mm x 150 mm (Motorized)
Sample Mount
Sample size : Open space up to 150 mm x 150 mm, thickness up to 20 mm (optional 200 mm)
Sample weight : < 500 g
Optics
10x (0.28 NA) ultra-long working distance lens (1 µm resolution)
Direct on-axis vision of sample surface and cantilever
Field-of-view : 480 × 360 µm (with 10× objective lens)
CCD : 1 M pixel, 5 M pixel (optional)
Software
SmartScan™
Dedicated system control and data acquisition software
Adjusting feedback parameters in real time
Script-level control through external programs (optional)
XEI
AFM data analysis software (running on Windows, MacOS X, and Linux)
Electronics
High performance DSP : 600 MHz with 4800 MIPS
Maximum 16 data images
Maximum data size : 4096 × 4096 pixels
Signal inputs : 20 channels of 16 bit ADC at 500 kHz samplings
Signal outputs : 21 channels of 16 bit DAC at 500 kHz settling
Synchronous signal : End-of-image, end-of-line, and end-of-pixel TTL signals
Active Q control (optional)
Cantilever spring constant calibration (optional)
CE Compliant
Power : 120 W
Signal Access Module (Optional)
AFM Modes
(*Optionally available)
Standard Imaging
True Non-Contact AFM
Basic Contact AFM
Lateral Force Microscopy (LFM)
Phase Imaging
Tapping AFM
Force Measurement*
Force Distance (F/d) Spectroscopy
Force Volume Imaging
Dielectric/Piezoelectric Properties*
Electric Force Microscopy (EFM)
Dynamic Contact EFM (EFM-DC)
Piezoresponse Force Microscopy (PFM)
PFM with High Voltage
Mechanical Properties*
Force Modulation Microscopy (FMM)
Nanoindentation
Nanolithography
Nanolithography with High Voltage
Nanomanipulation
Magnetic Properties*
Magnetic Force Microscopy (MFM)
Electrical Properties*
Conductive AFM (C-AFM)
IV Spectroscopy
Kelvin Probe Force Microscopy (KPFM)
KPFM with High Voltage
Scanning Capacitance Microscopy (SCM)
Scanning Spreading-Resistance Microscopy (SSRM)
Scanning Tunneling Microscopy (STM)
Photo Current Mapping (PCM)
Chemical Properties*
Chemical Force Microscopy with Functionalized Tip
Electrochemical Microscopy (EC-AFM)
AFM Options
Temperature Control
Temperature Controlled Stage 1
-25 °C to +170 °C
Temperature Controlled Stage 2
Ambient to +250 °C
Temperature Controlled Stage 3
Ambient to +600 °C
Liquid Cells
Universal Liquid Cell
Open or closed liquid cell with liquid/gas perfusion
Temperature control range: 0 °C to +110 °C (in air), 4 °C to +70 °C (with liquid)
Electrochemistry Cell
Liquid Probehand
Designed for imaging in general liquid environment
Resistant to most buffer solutions including acid
Contact and Non-contact AFM imaging in liquid
Encoders for Motorized Stage
• The encoded XY stage travels in 1 µm resolution with 2 µm repeatability
• The encoded Z stage travels in 0.1 µm resolution with 1 µm repeatability
Dimensions in mm





