Park NANOstandard
The calibration standard samples for atomic force microscopy (AFM) and scanning electron microscopy (SEM) measurements.
Manufactured by Kims Reference Corp.
AFM Tip Characterizer (AFMTC)
AFMTC sample consists of 10 Multiple Narrow Trenches (10 ~ 50 nm) and a 50 nm Isolated Line.
This calibration sample provides users with a certified reference material to evaluate the performance for nanoscale narrow trench measurement and the shape characterization of AFM tips.

Specifications :
Trench widths: 10 nm, 13 nm, 16 nm, 19 nm, 22 nm, 26 nm 30 nm, 35 nm, 40 nm, 50 nmLine widths: 50 nm
Step height: 100 nm (not certified)
Pattern length: 4.0 mm (certified region: 3 mm from center)
Material: Polycrystalline silicon
Traceability: KOLAS* (KRISS**) traceable via ISO 17034:2016
High Magnification Calibrator (HMC)
The HMC sample consists of a set of lines that provides five different width and pitch references.
This calibration sample offers users with a certified reference Nanometric Ruler to calibrate the horizontal scale of AFM measurement or SEM magnification. It also comes with a statistical analysis template (an Excel file), an automatic calculation tool that allows users to obtain the calibration parameters accurately and easily.
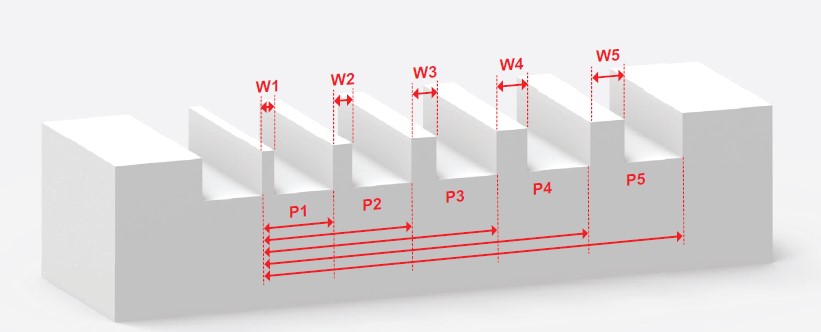
Specifications :
Line widths (W1~W5): 5 certified values within 20 nm ~ 80 nmPitch values (P1~P5): 5 certified values within 100 nm ~ 900 nm
Step height: 70 nm (not certified)
Pattern length: 4.0 mm (certified region: 3 mm from center)
Material: Polycrystalline silicon
Traceability: KOLAS* (KRISS**) traceable via ISO 17034:2016




