High productivity and powerful features for inline wafer-fab metrology
Automatic Defect Review for Bare Wafers and Substrates
300mm의 새로운 웨이퍼 ADR은 결함 지도의 전송과 정렬부터 결함의 측량과 줌-인 스캔 이미징까지 전자동의 결함검토 공정을 제공하며, 이 공정은 샘플 웨이퍼에 참조 표시를 하지 않는 독특한 재배치 과정을 사용합니다. 사용 후 결함 장소에 사각형 모양의 파괴적인 조사 자국을 남기는 SEM과는 다르게, AFM에 의한 결함의 검토는 수 나노미터에 불과한 결함의 비파괴적인 3D 이미징이 가능합니다. 향상된 영상기법과 함께 진보된 좌표 변형은 결함 점검 툴과 AFM사이를 연결합니다. 웨이퍼 ADR은 전자동화가 되어있기 때문에, 목표 결함 검토 시스템을 보정하기 위한 단계를 설정하지 않으며, 스루풋을 최대 1,000% 가량 증가시킵니다.
Read More related application
Automatic Transfer and Alignment of Defect Maps with Enhanced Vision
Park Systems 소유의 좌표 변형 기술을 통해, 새로운 ADR AFM은 레이저-스캐터링 결함 점검 툴로부터 얻어진 결함 지도를 300mm AFM 시스템으로 전송할 수 있습니다. 이 기술은 목표 결함 검토 시스템을 보정하기 위한 단계를 설정하지 않으며 결함 이미징의 높은 스루풋을 위해 전자동화 되어있습니다.

Automated Search & Zoom-in Scan
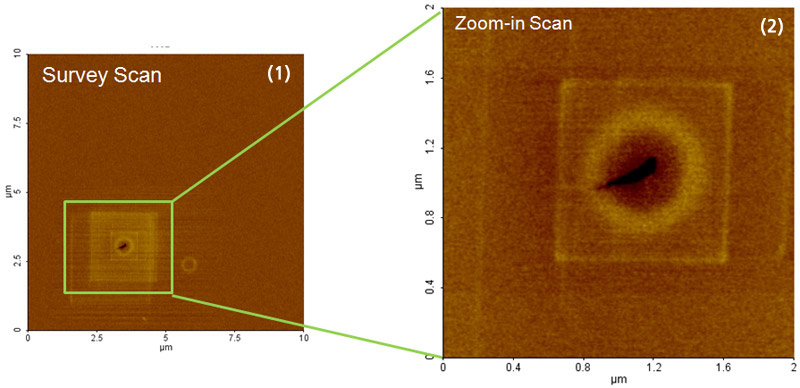
결함은 두 단계로 이미징됩니다.
(1) 결함의 위치를 개선하기 위해 AFM 혹은 향상된 광학렌즈에 의한 측량 이미징
(2) 결함의 종류와 차후 결함 면적의 자동 분석을 제공하며, 상세한 결함 이미지를 얻기 위한 줌-인 AFM 스캔
Long Range Profiling for CMP Characterization
금속재료와 유전체가 사용된 말기 공정에서 평탄과는 가장 중요한 단계입니다. 화학적 기계적 연마(CMP) 이후에 제품의 지역적 그리고 세계적인 균일성은 칩 생산량에 상당한 영향을 끼칩니다. 정확한 CMP 프로파일링은 최고의 평탄성과 제품의 높은 수율을 위해 매우 중요한 계측법 입니다.
Park Systems의 NX-Wafer는 이동 스테이지와 함께 CMP 계측을 위한 광범위 프로파일링이 가능합니다. Park Systems의 자동 AFM만의 독특한 스캐너 설계에 의해, 시스템은 매우 평평한 프로파일링을 제공하며 각각의 측정 이후의 복잡한 배경제거 혹은 보정을 요구하지 않습니다. NX-Wafer는 디싱, 부식, EOE를 포함한 평면성 측정에 있어서 최고의 CMP 계측법을 제공합니다.
Sub-Angstrom Surface Roughness Control
디바이스의 크기가 날로 줄어들고 있기 때문에 반도체 공급업체들은 극도로 평평한 웨이퍼를 개발하고 있습니다. 하지만, 아직까지 옹스트롬 이하의 거칠기를 가진 기판의 표면을 정확하게 측정하는 계측 툴은 존재하지 않았습니다. 시장 내 최저 수준인 0.5 Å미만의 노이즈 플로어를 제공하는 것과 더불어 Park Systems의 완전 비접촉 모드 TM를 탑재한 NX-Wafer는 최소한의 팁-팁 변화를 가지고 매우 평평한 기판과 웨이퍼의 옹스트롬 이하의 거칠기를 정확하고 반복할 수 있으며, 복제할 수 있게 측정합니다. 최대 100m x 100m 크기의 광범위한 파형의 스캔 측정도 매우 정확하고 반복적으로 할 수 있습니다.
High-Throughput Wafer-Fab Inspection and Analysis
• 최소의 택트타임과 99.9%의 성공률을 가지는 자동 팁 교환
• 자동 웨이퍼 핸들링을 위한 EFEM(Equipment Front End Module)
• 청정실에 적합하며 원격 제어 가능
• 트렌치 폭, 깊이, 각도에 대한 자동 데이터 측정 및 분석
Park NX-Wafer features
50mm Long Range Profiler
원자력 프로파일러(AFP)에 있어서 광범위한 프로파일러는 필수적인 요소이며, 자동 CMP 프로파일링과 분석을 위한 전용 사용자 인터페이스를 탑재하고 있습니다.
• Maximum sliding range: up to 50mm
• 면외운동(OPM): less than ± 10 nm @ 10 mm range
• 데이터 포인트의 개수: 최대 1,048,576
100 µm x 100 µm Flexure-Guided XY Scanner with Closed-loop Dual Servo System
XY 스캐너는 대칭인 2차원 플랙셔와 고출력 압전기 스택으로 구성되며, 면 외 운동을 최소화 하는 동시에 정확한 직각 움직임이 가능합니다. 또한, 나노미터 스케일의 정밀한 샘플 스캐닝에 필수적인 높은 민감도를 지니고 있습니다. 두 개의 대칭적인 저소음(노이즈) 위치센서는 각각의 XY 스캐너 축에 결합되어 최대의 스캔 범위와 샘플 사이즈를 위해 높은 스캔 직교성을 유지합니다. 보조 센서는 하나의 센서만을 사용했을 경우 발생되는 비선형과 비평면 위치상의 에러를 정정함과 동시에 보완해줍니다.
15 µm High Speed Z Scanner with Low Noise Position Sensor
NX-Wafer는 비선형인 Z 전압신호 대신 극 저 노이즈 Z 검출기를 이용하여 형상 높이를 매우 정확하게 측정합니다. 업계를 선도하는 저 노이즈 Z 검출기는 형상 신호로서 Z 인가 전압을 대체합니다. 큰 힘을 갖는 압전 작동기와 유연 구조물에 의해 작동되는 표준 규격의 Z 스캐너는 9 kHz(일반적으로 10.5 kHz)보다 큰, 높은 공명주파수를 가집니다. 또한 정확한 피드백을 가능하게 하는 Z-서보 속도를 가지며 이것의 팁의 속도는 48 mm/초 보다 높습니다. 선택적으로 긴 스캔범위의 Z 스캐너를 장착한다면 최대 Z 스캔범위는 15µm에서 30µm까지 확대될 수 있습니다.
Automatic Measurement Control so you can get accurate scans with less work
 NX-Wafer는 자동화 소프트웨어를 통해 작업을 매우 수월하게 합니다. 원하는 측정 프로그램을 선택하기만 하면 정확한 다지점 분석결과를 얻을 수 있습니다. 분석결과는 캔틸레버 튜닝, 스캔 속도와 게인, 그리고 셋 포인트 파라미터의 최적화된 세팅을 포함합니다.
NX-Wafer는 자동화 소프트웨어를 통해 작업을 매우 수월하게 합니다. 원하는 측정 프로그램을 선택하기만 하면 정확한 다지점 분석결과를 얻을 수 있습니다. 분석결과는 캔틸레버 튜닝, 스캔 속도와 게인, 그리고 셋 포인트 파라미터의 최적화된 세팅을 포함합니다.
사용자는 Park Systems의 사용자 친화적 소프트웨어 인터페이스를 이용하여 맞춤형 작업 루틴을 융통적으로 생성하는 것이 가능합니다. 따라서 사용자는 NX-Wafer십분 활용할 수 있으며 원하는 측정 결과를 얻을 수 있습니다.
새로운 루틴을 만들어 내는 것은 쉬운 작업입니다. 하나의 루틴을 생성하는 데에는 10분 가량이 소요되며 기존의 루틴을 수정하는 데에는 5분 미만이 소요됩니다.
Park NX-Wafer’s automated system features:
• 완벽한 컨트롤이 가능한 자동, 반자동, 수동 모드
• 자동화된 개별 루틴의 수정이 가능한 측정 방법
• 측정 프로세스의 실시간 모니터링
• 획득한 측정 데이터의 자동 분석





