インライン ウエハ計測の為の高い生産性と強力な機能
ベア ウエハとサブストレート用自動欠陥検査機能
新しい300mmベア ウエハの自動欠陥検査(ADR)は、サンプル ウエハ上にマーキングすることなく欠陥のサーベイスキャンと拡大再スキャンを行うユニークな機能を持ち、画像データの転送やアライメントも完全に自動で行うことができます。欠陥を観察した後に正方形の破壊的なビーム照射跡を残すSEMとは異なり、新しいPark ADRは、強化されたビジョン機能によりウエハのエッヂから座標を検出を行い外部の欠陥検査ツールとAFMとの座標リンケージを自動的に行います。完全な自動化により、欠陥検査装置のステージを較正するステップを必要とせず、結果的に最大1,000%のスループットを向上させることができます。.
Read More related application
エンハンスト ビジョン ソフトウエアによる欠陥マップの自動転送 & アライメント
パーク社の高い性能な座標変換技術によって、新Park ADR AFMは、レーザー散乱式欠陥検査ツールからの欠陥マップを300mm ParkAFMシステムに正確に転送できます。この技術により、欠陥検査のステージをキャリブレーションする別のステップの必要もなく、高スループット欠陥イメージングの完全な自動化を実現できます。.

自動サーチ & 拡大スキャン
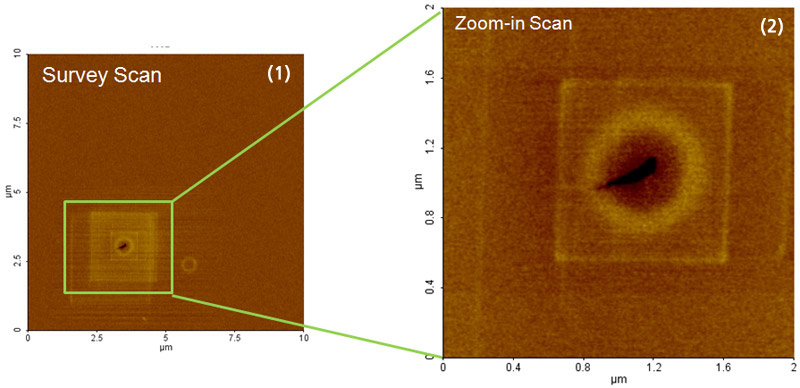
欠陥は、2ステップで画像化されます;(1)サーベイスキャンでは、AFMあるいは強化された光学ビジョンのいずれかによって、欠陥位置を見つける。その後で(2)AFMで拡大スキャンを行い欠陥の詳細なイメージを得る、自動的に欠陥タイプと寸法を解析する。 .
CMP特性検査の為のロング レンジ プロファイリング機能
平坦化は、メタルや誘電体材料が使用されているバックエンド プロセスの中で重要なテップです。化学機械研磨(CMP)後の局所的或いは広域における均一性は、チップ製造のスループットに非常に影響を及ぼします。正確なCMPプロファイリングは、平坦化のプロセスにおける生産性向上条件の最適化に必要とされる非常に重要な計測技術です。 スライディングステージとPark NX-Waferを組み合わせることで、CMP計測における長距離プロファイリング機能が可能になりました。独自のスキャナ設計を持つPark社自動AFMは、非常に平坦なプロファイリングを提供する為に、複雑なバックグラウンドの減算や、測定後の様々なキャリブレーションの必要がありません。Park NX-Waferはディッシング、エロージョン、エッジオーバーエロージョン(EOE)を含む居所的或いは、広域の平坦測定で前例のないCMP計測を可能にします。
サブÅ表面粗さ制御
半導体サプライヤーは、デバイス寸法が更に縮小化するニーズが増加する事へ対処するために、超フラット ウエハを開発しています。しかし、これらの基板表面のサブ オングストロームの粗さを正確で信頼性の高い測定が可能な計測ツールは、これまでありませんでした。ウエハ全領域で0.5A未満の業界最小のノイズフロアと真のノンコンタクト™モードを組み合わせることにより 、Park NX-Waferは最もフラットな基板やウエハに対し、チップ間のバラツキを最小化し、正確で再現性の高いサブ Å粗さ計測を実現しました。最大走査サイズ100μm x 100μmの広範囲なうねり測定においても非常に正確で再現性の高い表面測定ができます。
高スループット インライン ウエハ検査と解析
• 99.9%の成功率と最小限のタクトタイムでの自動チップ交換
• 自動ウエハー処理のための器材Front End Module(EFEM)
• クリーンルーム互換性と遠隔操作インターフェース
• 溝幅、深さと角度寸法の自動データ収集と分析
Park NX-Wafer 特徴
50mm 長距離 プロファイラー
長距離プロファイラーは、原子間力プロフィル(AFP)の必須成分であり、自動化されたCMPプロファイリングおよび解析のための専用のユーザーインターフェースが付属しています。
• 最大スライディング範囲: 50mmまで
• 非平坦モーション (OPM): ± 10 nm 以下/ 10 mm
• 最大データポイント数: 1,048,576まで
100 μm x 100 μm フレクチャー式XYスキャナ(デュアル サーボシステム内臓)
XYスキャナは、2つの対称な高力スタックピエゾ(フレクチャー式)で構成されており、非常に高い直交性と平坦性、更にはナノスケールの詳細なサンプル測定に不可欠な高速応答性も持っています。2つの対称した低ノイズポジションセンサー(デュアル センサー)がX、Yスキャナのそれぞれの軸に対して、独自に作動する為に長距離スキャンの場合でも高い基準で直交性を維持します。2次センサーは、1次センサーで残ったノンリニアリティや非平坦性分を更に補正・修正してくれます。
15 μm 高速 Zスキャナ(低ノイズセンサー内蔵)
NX-Waferは、本質的に非線形性であるピエゾのZ電圧信号の代わりに、超低ノイズZ検出器を利用することで、これまでに無い正確さでトポグラフィ計測を可能にしています。業界最高の低ノイズZ検出器の信号が、トポグラフィの信号としてZ印加電圧に代わって使用されます。フレクチャー技術を採用した高力ピエゾスタックによってドライブされる標準Zスキャナが、9kHz以上(標準10.5kHz)の高い共振周波数で、48mm/秒以上の速度でも正確にZサーボへのフィードバックが可能です。最大Z走査範囲は、オプションにより、15μmから30μmまで拡張することができます。
自動計測制御によって負荷の無い正確な計測が可能
 NX-Waferは、容易な操作が可能な自動ソフトウェアを装備しています。カンチレバーのチューニング、スキャンレート、ゲイン及びセットポイント パラメータが予め最適化されたマルチサイト分析プログラムを任意に選択するだけで測定を開始できます。
NX-Waferは、容易な操作が可能な自動ソフトウェアを装備しています。カンチレバーのチューニング、スキャンレート、ゲイン及びセットポイント パラメータが予め最適化されたマルチサイト分析プログラムを任意に選択するだけで測定を開始できます。
パーク社のユーザーフレンドリなソフトウェア インターフェースは、お客様がNX-Waferをフルパワで使用する為に、希望するオペレーションに沿って柔軟にカスタマイズを可能としています。
新しいルーチンを作成することは簡単です。ゼロからの作成でおよそ10分、または既存のものを修正するのに必要な時間は5分以下です。
Park NX-Wafer 自動システムの特徴:
•自動、半自動、完全マニュアル モード
• 測定プロセスのライブ モニタリング
• 各自動ルーチンにおける測定方法の編集
• 測定データの自動解析





